
塑封是廣泛應(yīng)用的5G電子封裝技術(shù)之一。其封裝的基板和塑封料主要成分是樹脂,具有親水性和多孔性。當(dāng)水分進(jìn)入封裝中,會(huì)使得塑封的電子元器件發(fā)生由于吸濕引起的界面層破裂和電子元器件的整體失效破壞,甚至發(fā)生“爆米花”式的斷裂。所以如美國(guó)空軍航空電子完整性項(xiàng)目發(fā)現(xiàn)的,濕度也是引起電子產(chǎn)品失效的重要因素。
對(duì)吸濕分析而言,最主要是依據(jù)濕度的擴(kuò)散機(jī)理,獲取封裝中濕度分布,最后分析濕度應(yīng)力。采用菲克第二定律(Fick’s second law)來預(yù)測(cè)隨著時(shí)間變化,擴(kuò)散對(duì)濃度分布的影響:

同時(shí)為了求解濕度應(yīng)力,需要熱-結(jié)構(gòu)-擴(kuò)散直接耦合單元22X系列求解計(jì)算。通過以上濕度擴(kuò)散和耦合單元,可以獲得封裝結(jié)構(gòu)濕度分布和濕應(yīng)力狀態(tài),用于找出封裝結(jié)構(gòu)薄弱區(qū)域。參考GB2423.3-93等行業(yè)標(biāo)準(zhǔn),可以對(duì)封裝在濕度環(huán)境下進(jìn)行試驗(yàn):
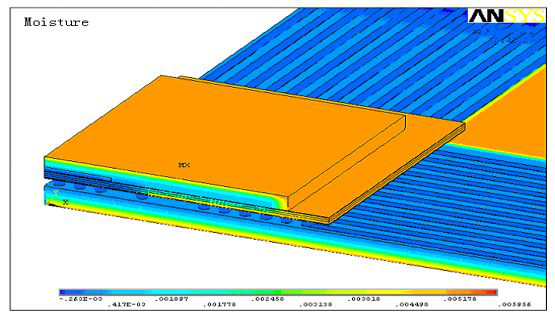
封裝中濕度濃度分布
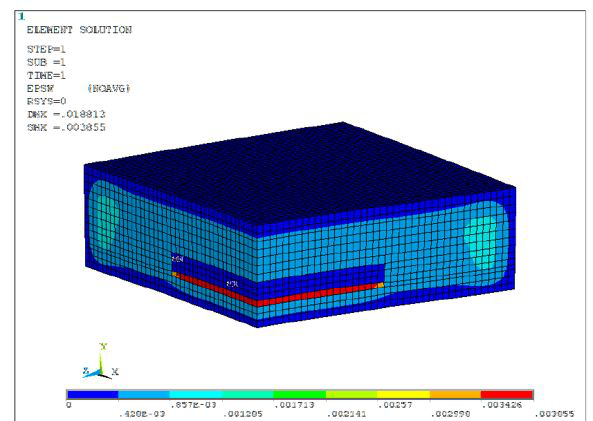
封裝中濕應(yīng)力引起的應(yīng)變
本篇我們先對(duì)PCB/封裝在潮濕環(huán)境下吸濕膨脹(爆米花效應(yīng))進(jìn)行了討論,歡迎和瑞凱儀器繼續(xù)探討5G設(shè)備可靠性試驗(yàn)相關(guān)技術(shù)問題。


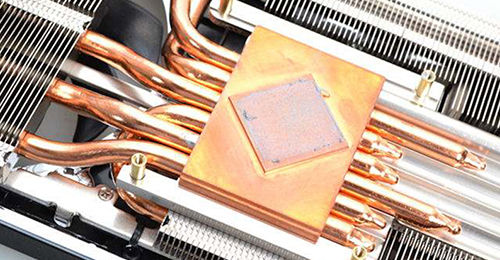

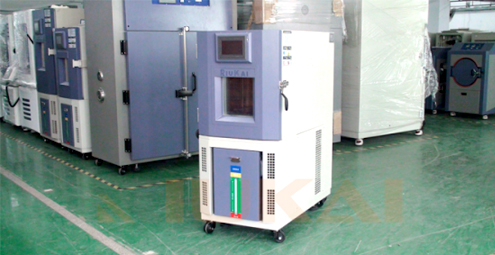



 客服微信
客服微信