
作為5G元年的2019已經過去,隨著四大運營商的基礎設施投資和建設的不斷推進,2020年將正式邁入5G時代,很快我們將體驗到前所未有的5G工作和生活場景。利用更高速率、更寬帶寬、更高可靠性、更低時延的5G技術,給生產和生活帶來翻天覆地的變化。
5G是一個萬物互聯的時代,機器與機器能夠通信將成為普遍的特點。據賽迪智庫《5G十大細分應用場景研究報告》,5G將在VR/AR、超高清視頻、車聯網、聯網無人機、遠程醫療、智慧電力、智能工廠、智能安防、個人AI設備、智慧園區等方面大放異彩,具有非常廣闊的前景。對于這些應用場景來說,依賴于5G的基礎設施以及支撐技術的云計算,邊緣計算,AI等關鍵技術,搭配場景終端設備,可完成極其豐富的功能和體驗。
對于5G設備,比如5G智能手機、網絡環節的片上系統(SoCs)、射頻集成電路(RFIC)等,在有溫度和功耗限制的環境下,需要具備強大的數據處理能力,其可靠性設計是必須重點考慮的一個方面,尤其需要從芯片、封裝、系統多層次考慮其熱可靠性以及結構可靠性。
本文將重點討論電子產品結構可靠性設計方面的典型問題及其仿真解決思路。
1. 電子產品對結構可靠性的要求
據美國空軍航空電子整體研究項目(US Air Force Avionics Integrity Program)發現,電子產品失效主要是由溫度、振動、潮濕和粉塵引起。5G電子產品的性能和指標要求就更加苛刻,拿最典型的終端產品——手機來說,其5G功能工作在更高的頻段,物理尺寸更加緊湊,電磁損耗更集中,其性能卻更容易受到溫度的影響,以及受到長時間外部使用環境的影響,因此,其具有更高的結構可靠性要求。

對于電子產品結構可靠性分析來說,可以從部件、系統兩個維度進行分析;當然,電子產品可靠性也是一個復雜的多物理場分析過程。比如5G芯片設備,先進封裝技術是保障5G芯片設備發揮極限性能,且低功耗要求的關鍵技術,高可靠性的封裝就是5G芯片設備能長時間安全運行的保證。
時下先進的2.5D IC / 3D IC封裝技術,包括通過硅通孔(TSV),管芯和晶片堆疊,系統封裝(SiP),層疊封裝(PoP),高級晶圓級封裝(WLP),將成為5G芯片封裝設計的主流選擇。短互連路徑由于提高了I / O速度,堆疊芯片之間的TSV實現更高的性能。它們還消耗較低的功率,因為堆疊了多個管芯,因此減小了電容并減小了尺寸。盡管這是一個非常有前途的技術,但由于其復雜性,仍充滿了挑戰。
系統層面,組裝在一起的5G終端產品,還需考慮整機設備的變形、振動、跌落碰撞、散熱等問題。而這些問題,都是典型的結構可靠性和熱可靠性方面的問題。
2. PCB/封裝的結構可靠性
如前所述,先進封裝是5G芯片設備的關鍵技術,而日益增長的性能要求和嚴苛的使用環境,對先進封裝的結構可靠性也提出了很大的挑戰。典型的問題有如下幾個方面,后面的分析也將在這幾個方面展開。
PCB/封裝在循環溫度作用下的翹曲分層
PCB/封裝在潮濕環境下吸濕膨脹(爆米花效應)
封裝器件在振動沖擊作用下失效等
封裝焊球在溫度循環下產生疲勞裂紋和失效
2. 1 PCB/封裝在Flip Chip工藝+循環溫度作用下的翹曲變形
在半導體行業,Flip Chip工藝廣泛用于PCB/封裝等器件連接,在此工藝下,封裝就會有殘余變形和應力的產生,也有塑性應變的存在。當PCB/封裝連接后,還會對其進行相應的溫度循環測試。使用Ansys Mechanical工具對整個流程進行仿真,可以了解Flip Chip工藝產生的塑性狀態對后續溫循仿真的影響。
對于PCB/封裝仿真而言,想要得到準確仿真結果,PCB和封裝的材料屬性是關鍵。但對于PCB和封裝的結構過于復雜,且特征尺寸小,如果按傳統分網格的方法,網格量會巨大,操作起來也不現實;如果考慮計算效率,對每層PCB板賦予相同材料屬性,那計算精度就會大打折扣。
那有沒有一種既考慮精度又能兼顧效率的方法?
答案是肯定的! “Trace Mapping” 正好可以解決PCB仿真的材料模型計算的難題。
所需試驗設備:高低溫循環試驗箱


仿真模型和溫度條件
通過SCDM導入EDA軟件里建立的PCB板模型,考慮每一層每個位置的含銅率,計算每一層PCB每個位置的熱物參數(各向異性),比如:密度、導熱系數、熱膨脹率、泊松比等。
然后通過trace import將計算的詳細熱物參數導入到Mechanical中,Map到多層矩形板上,Map后的矩形板雖然不具有原來PCB板的幾何結構和特征,但是具有原來PCB板的詳細熱物參數。
因為進行熱力計算時,影響熱力仿真準確性的主要是PCB板自身的熱物參數準確性,所以即使矩形板沒有詳細幾何特征,也可以進行準確的熱力計算。
使用Trace Mapping方法準確計算PCB各處的材料屬性,再結合生死單元、子模型方法,就可以對Flip Chip+溫循工藝進行多尺度精確分析,得到PCB/封裝結構的受力和變形。

Layer7 Dielectric Metal

封裝中金屬和介質材料等效應力
本篇我們先對PCB/封裝在循環溫度作用下的翹曲分層進行了討論,下一篇我們將對PCB/封裝在潮濕環境下吸濕膨脹(爆米花效應)進行討論,歡迎和瑞凱儀器繼續探討5G設備可靠性試驗相關技術問題


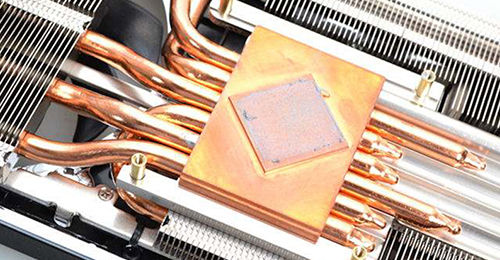

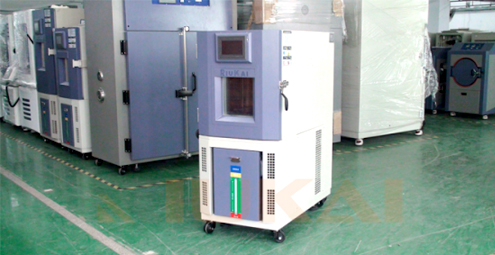



 客服微信
客服微信